
為(wéi)了提高肖特基二極管的雪崩耐(nài)量,以避免元器件的雪崩損壞,三安集成電路在18年10月29日申請了一項名為“新型碳化矽結勢壘(lěi)肖特基二極管及其(qí)製作(zuò)方法”的發明專利(申請號:201811267285.X),申請人為廈門市三安集成電路有限公司。
根據(jù)目前該專利公開的資料,讓我們一(yī)起來看(kàn)看這(zhè)項肖特基二極管專利吧。
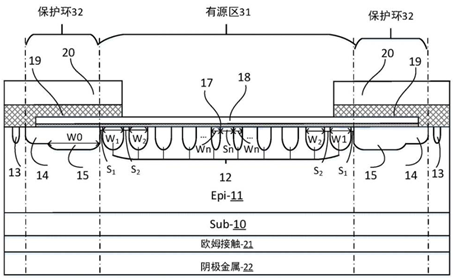
如上圖為新型碳化矽結勢壘肖特基二極管(guǎn)的分層(céng)結構圖,該結構中包(bāo)括層(céng)疊設置的第一導電類(lèi)型碳化矽(guī)襯底10和第一導(dǎo)電類型碳化矽外延層11。第一導電類型碳化矽外延層的上表麵由中心(xīn)向外依次設置有有(yǒu)源區31、保護環32和第二導電類型終端場限環13,有源區包括間隔設置的多個第(dì)二(èr)導電類型結勢壘區(qū)12。
沿著保護環向有源區的中心的方(fāng)向,相鄰第二導電類型結勢壘區的間(jiān)距逐漸增大,且第二(èr)導電類型結勢壘(lěi)區的寬度逐漸減小。有源區包括n個第二(èr)導電類型結勢(shì)壘(lěi)區,靠近保護環的第一個結勢壘區的寬度W1為1-15um;保護環32與第一個結勢壘區的間距S1為0.5-8um;第n個第二(èr)導(dǎo)電類型(xíng)結勢壘區的寬度Wn為0 .5-4um,第n-1個第二導電類型結勢壘區與第n個第二導電類型結勢壘區的間距Sn為5-10um。
這(zhè)樣的(de)結構,主要(yào)是因為結勢壘區之間的間隔逐漸增大後,當施加的反向偏壓不斷增加,有源區靠近(jìn)中心處結勢壘區之間的間距較大,肖特基結的電場強度較大,由於肖特基效應,導致該區域的肖特基勢壘高度降低,成為(wéi)擊穿薄弱點,因此將擊穿(chuān)點引入到有源區中(zhōng)心區域,增加(jiā)了(le)雪崩狀(zhuàng)態下的散熱麵(miàn)積,從而提高了雪崩耐量!

如上圖所示,每一個第二導電類型結勢壘12區包(bāo)括一個子結勢壘(lěi)區,並且第二導電類型結勢壘區為長(zhǎng)條形,沿著保護環的兩側向(xiàng)有源區31的中心的方向,相鄰第二導電類(lèi)型結勢壘區的間距逐漸增大,且第(dì)二導(dǎo)電類型結勢壘區的寬度(dù)逐漸減小。
下麵我們再(zài)來聊(liáo)聊這種新型碳化矽結勢壘(lěi)肖特基二極管的製作方法,如下圖所(suǒ)示。
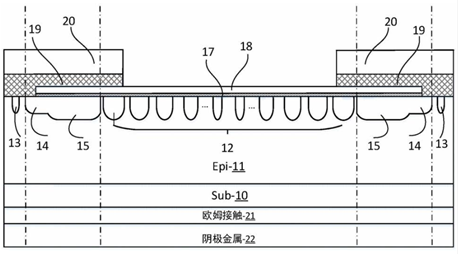
首先,準備碳化(huà)矽襯底10,其電阻率為0.001-0.05Ω·cm,厚度(dù)200-380um。在碳化矽襯底上,生長(zhǎng)第一導電類型的碳化矽外延層11,在(zài)碳(tàn)化矽外延層上表麵,通過澱(diàn)積(jī)SiO2、光刻、選擇性離子注入形成間(jiān)隔設置的多個(gè)第(dì)二導電類型結(jié)勢壘區12和深結15,深結位於第二導電類型結勢壘區外,並且深結和第二導電類型結勢壘區的深度相同。
多個第二導電類型結勢壘區沿著由外向內的方向,相鄰第二導電類型結勢壘區的間距逐漸增大,且第二導電類型結勢壘區12的寬度逐漸(jiàn)減小。在碳化矽外延層上表麵,通過光刻、選擇性離子注(zhù)入形成深度相同(tóng)的第二導電類型終端(duān)場限環13和淺結14。
接著,通過物理研磨,將碳化矽襯底(dǐ)的背麵減薄至200-220um,在碳化矽襯底的背麵(miàn)通過電子束蒸發(fā)澱積(jī)金屬Ni,並在900℃下退火形成歐(ōu)姆接觸21,在碳(tàn)化矽外延層上表麵,通(tōng)過電子束蒸發或濺鍍,澱積金屬Ti,並在500℃下退火(huǒ)形成肖特(tè)基金屬(shǔ)17。
最後,在肖特基金屬的上(shàng)表麵,通(tōng)過電子束蒸發澱積金屬Al,形成陽極18,在碳化矽外延層上表麵(miàn)及陽極(jí)金屬(shǔ)的上表麵,通過PECVD,澱積形成(chéng)SiO2/Si3N4層,通過光刻、形(xíng)成鈍化層19,在鈍化層的上表麵,通過澱積、光(guāng)刻形成(chéng)保護層20,在歐姆接觸21的(de)下表麵(miàn),通過澱(diàn)積,形成TiNiAg陰極金屬22。
以上就是(shì)三安集成電路的(de)新型碳化矽結勢壘肖特基二極管(guǎn)發明專利,二極管是電子產品的主要部件之一,優質的二極管是保(bǎo)證電子產品穩定(dìng)性的源頭,而三安集成電路這項專(zhuān)利正好(hǎo)填補了這方麵的空缺(quē),從而使得電子產品的質(zhì)量大大提高!